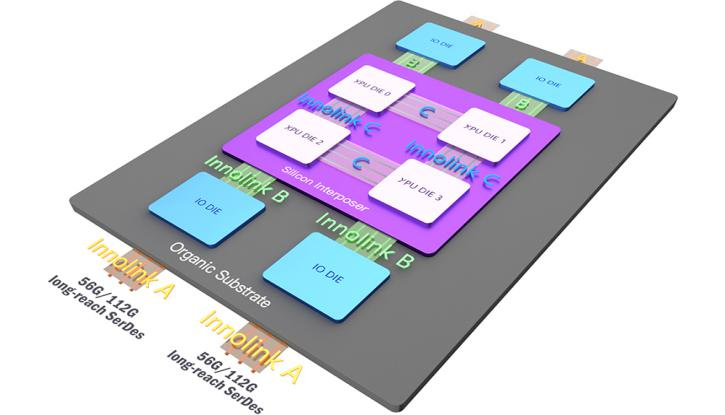
2022 年 3 月,芯片制造商英特尔、台积电、三星联合日月光、AMD、ARM、高通、谷歌、微软、Meta(Facebook) 等十家行业巨头共同推出了全新的通用芯片互联标准——UCle。
2022 年 3 月,芯片制造商英特尔、台积电、三星联合日月光、AMD、ARM、高通、谷歌、微软、Meta(Facebook) 等十家行业巨头共同推出了全新的通用芯片互联标准——UCle。
几乎与此同时,中国 IP 和芯片定制及 GPU 赋能型领军企业芯动科技宣布率先推出国产自主研发物理层兼容 UCIe 标准的 IP 解决方案-Innolink™ Chiplet,这是国内首套跨工艺、跨封装的 Chiplet 连接解决方案,且已在先进工艺上量产验证成功!
▲ Innolink™ Chiplet 架构图
随着高性能计算、云服务、边缘端、企业应用、5G 通信、人工智能、自动驾驶、移动设备等应用的高速发展,算力、内存、存储和互连的需求呈现爆炸式增长。但同时,先进工艺芯片迭代也面临着开发难度大、生产成本高、良品率低的窘境,即先进制程工艺下芯片面临着性能与成本的矛盾,Chiplet 技术在这一背景下得到快速发展。
▲ 制程工艺发展和晶体管密度增加导致开发成本急剧上升
Chiplet 技术的核心是多芯粒 (Die to Die) 互联,利用更短距离、更低功耗、更高密度的芯片裸 die 间连接方式,突破单晶片 (monolithic) 的性能和良率瓶颈,降低较大规模芯片的开发时间、成本和风险,实现异构复杂高性能 SoC 的集成,满足不同厂商的芯粒之间的互联需求,达到产品的最佳性能和长生命周期。
▲ Chiplet 核心技术是多芯粒互联
近年,AMD、苹果和英伟达等国际巨头都发布了标志性的 Chiplet 旗舰产品,并在各个应用领域取得极大成功,进一步验证了 Chiplet 技术的可行性和发展前景,使得 Chiplet 互联这一核心技术日益受到市场追捧!
▲ 多芯粒互联的 Chiplet 技术是实现高性能异构系统的发展趋势
▲ 苹果自研 M1 Ultra 芯片应用 Chiplet 技术实现性能翻倍
Chiplet 早期发展协议混乱 各公司制定自己的私有标准
此前,众多的芯片厂商都在推自己的互联标准,比如 Marvell 在推出模块化芯片架构时采用了 Kandou 总线接口;NVIDIA 拥有用于 GPU 的高速互联 NV Link 方案;英特尔推出了 EMIB (Embedded Die interconnect bridge) 接口;台积电和 Arm 合作搞了 LIPINCON 协议;AMD 也有 Infinity Fabrie 总线互联技术等等。芯动科技奋起直追紧随其后,2020 年在国内率先推出自主研发的 Innolink™ Chiplet 标准并实现授权量产。
Chiplet 技术核心就是 Die to Die 互联,实现大带宽下的多芯片算力合并,形成多样化、多工艺的芯片组合。显然,如果各家芯片厂商都在推自己的标准,这将导致不同厂商的 Chiplet 之间的互联障碍,限制 Chiplet 的发展。因此,实现各个芯粒之间高速互联,需要芯片设计公司、EDA 厂商、Foundry、封测厂商等上下游产业链协调配合、建立统一的接口标准,从而实现 Chiplet 技术的量产应用并真正降低成本,加速整个 Chiplet 生态的发展。于是,UCIe 标准应运而生。
UCIe 的建立将有力推动 Chiplet 连接标准发展
前不久,UCIe 标准发布引起了业界高度关注与热议,因为这是由一条比较完整的产业链提出的开放的、可互操作性的标准,能有效解决当前先进工艺芯片产业上下游发展的难题,降低成本、提升性能。
Universal Chiplet Interconnect Express (UCIe)® 是一个开放的、行业通用的 Chiplet(芯粒)的高速互联标准,由英特尔、AMD、ARM、高通、三星、台积电、日月光、Google 、Meta、微软等十大行业巨头联合推出。它可以实现小芯片之间的封装级互连,具有高带宽、低延迟、低成本、低功耗等优点,能够满足包括云端、边缘端、企业级、5G、汽车、高性能计算和移动设备等在内的整个计算领域,对算力、内存、存储和互连日益增长的高需求。通俗来讲,UCIe 是统一标准后的 Chiplet,具有封装集成不同 Die 的能力,这些 Die 可以来自不同的晶圆厂,也可以是采用不同的设计和封装方式。
Innolink™ Chiplet 方案解读
▲ 芯动 Chiplet 架构师高专讲演 Innolink™ Chiplet 方案
就在 Ucle 标准发布后两周,芯动科技就宣布推出首个国产自主研发物理层兼容 UCIe 标准的 IP 解决方案-Innolink™ Chiplet。芯动 Chiplet 架构师高专表示:芯动在 Chiplet 技术领域积累了大量的客户应用需求经验,并且和台积电、intel、三星、美光等业界领军企业有密切的技术沟通和合作探索,两年前就开始了 Innolink™ 的研发工作,率先明确 Innolink B/C 基于 DDR 的技术路线,并于 2020 年的 Design Reuse 全球会议上首次向业界公开 Innolink A/B/C 技术。
得益于正确的技术方向和超前的布局规划,Innolink™ 的物理层与 UCIe 的标准保持一致,成为国内首发、世界领先的自主 UCIe Chiplet 解决方案。
▲ Innolink A/B/C 实现方法
Innolink™ Chiplet 的设计思路和技术特点:
1. 业界很多公司认为 Chiplet 跨工艺、跨封装的特性,会使其面临复杂的信号衰减路径,所以普遍使用 SerDes 差分技术以应对这一问题。芯动基于对 Chiplet 应用场景和技术趋势的深刻理解,以及在 DDR 技术领域的绝对领先,认为相较于 SerDes 路线,DDR 技术更适合 Chiplet 互联和典型应用,而且不同封装场景需要用到不同的 DDR 技术方案。
2.Chiplet(Die to Die) 在短距 PCB、基板、Interposer 上连接时,路径短、干扰少、信号完整性好,此时采用 DDR 技术路线在延时功耗和带宽密度上更具优势。在短距离 PCB、 基板、Interposer 平台上,DDR 对比 SerDes 的优势如下:
Chiplet 的核心目标就是高密度和低功耗,DDR 技术满足多芯粒互联的高密度、低功耗、低延迟等综合需求,可使多芯粒像单芯粒一样工作,单芯粒总线延展至多芯粒。因此,芯动综合考虑 SerDes 和 DDR 的技术特点,在 Innolink-B/C 采用了 DDR 的方式实现,提供基于 GDDR6/LPDDR5 技术的高速、高密度、高带宽连接方案。
3. 标准封装使用 MCM 传统基板作为 Chiplet 互联的介质,具备成本便宜等特点,是对成本较为敏感的 Chiplet 应用场景首选;先进封装如 Interposer,具备密度高、良品率低、成本高等特点,则是对价格不敏感的高性能应用场景首选。在 UCIe 定义正式发布前,Innolink-B/C 就提前实现了这两种封装场景的应用,验证了其对市场前景和 Chiplet 技术趋势的准确判断。
▲UCIe 定义不同封装标准的主要性能指标
4. 针对长距离 PCB、线缆的 Chiplet 连接,Innolink-A 提供基于 SerDes 差分信号的连接方案,以补偿长路径的信号衰减。
5. 总的来看,Innolink-A/B/C 实现了跨工艺、跨封装的 Chiplet 量产方案,成为业界领先!围绕着 Innolink™ Chiplet IP 技术,芯动同时还提供封装设计、可靠性验证、信号完整性分析、DFT、热仿真、测试方案等整套解决方案!
▲ Innolink™ Chiplet 的设计包含了 UCIe 的 Chiplet 连接先进、标准封装定义
图中显示 UCIe 分了 3 个层次,Protocol Layer 协议层、die to die Adapter 互联层、Physical Layer 物理层。其中协议层就是常用的 PCIE、CXL 等上层协议,底层的 Die to Die 和 PHY 物理层,即是和 Innolink™同样的实现方式。
总结:芯动准确地把握了 Chiplet 技术方向,并前瞻性地完成设计验证,与后来推出的 UCIe 技术方向一致,为 Innolink™ 兼容 UCIe 标准奠定基础,成为业界领先方案。
这听起来像押中高考大题的故事,其实 Innolink™背后的技术极为复杂,正因为芯动掌握了高速 SerDes、GDDR6/6X、LPDDR5/DDR5、HBM3、基板和 Interposer 设计方案、高速信号完整性分析、先进工艺封装、测试方法等等世界领先的核心技术,并且经过大量客户需求落地和量产验证迭代。博观而约取,厚积而薄发,「押中题」无疑是是芯动技术团队长期投入和耕耘的成果!
芯动准备了满满一桌的大餐 等着 UCIe 这个客人上桌!
Innolink™ Chiplet 是芯动先进 IP 之集大成者,代表着国内乃至世界领先水平,闻之不如见之,我们来盘点一下其内部实现的基础技术。
▲ 18Gbps GDDR6 单端信号量产验证
▲ 21Gbps PAM4 DQ eye, single ended
▲ HBM3 6.4Gbps 高速眼图
▲ 全球首个 GDDR6/6X combo IP 量产
▲ 32/56G SerDes 眼图
▲ 风华 1 号 4K 高性能 GPU 应用 Innolink™ Chiplet 实现性能翻倍
▲ 先进封装信号完整性分析
▲ 封装热效应仿真
看到这些赏心悦目的 IP 验证测试眼图,相信大家对 Innolink™ Chiplet 有了更加客观的认知。追本溯源,这些成果反映的另一问题也值得探讨,为什么芯动能在这么多先进技术上取得如此耀眼的成绩?
为什么要做先进 IP?有哪些挑战和困难?
芯动科技的 CEO 敖海先生是技术出身,长期保持和一线研发工程一起讨论架构、改代码、调电路、定方案的习惯,从领导人至一线员工,全公司都秉承踏实进取、勇于创新、务实精进的作风。见微知著,芯动研发团队能持续攻克一个个技术难关、攀登一座座行业高峰也就不奇怪了。正因于此,芯动才能保持对市场的敏锐判断和技术发展的持续领先!
▲ CEO 亲自参与研发工作,带领团队勇争领先!
敖海认为,现阶段先进工艺芯片技术迅速发展、高性能应用需求急剧增加,只有不畏挑战迎难而上、抢先占领技术高地,在 Chiplet 等先进 IP 技术上对标海外巨头,并在某些领域实现弯道超越,才能在市场上站稳脚跟,有效赋能国产半导体发展!
▲ 芯动科技 CEO 敖海先生
首发先进 IP 技术具备很多优势,可以快速赢得业界认可、第一时间导入客户需求并设计验证、广泛获得 Foundry 和封测等上下游的大力支持。在市场应用成熟时,还可以让广大芯片客户用上量产验证的、可靠安全的 IP,从而根据新的升级方向迅速实现技术迭代,进一步推动业务增长。一步领先、步步领先,从 IP 切入是极具实际意义的。
当然,首发推出先进工艺 IP 面临很多困难:
1. 没有参照对象,试错成本高。
第一个吃螃蟹的人,先进道路的开拓者,总要付出加倍的努力。在很多大的技术节点上并没摸石头过河的说法,需要不断的摸索尝试。通俗点讲就是一个个坑踩个遍,踩结实了,路就平了。
2. 对团队要求高。
一个先进 IP,从数字到模拟、后端到工艺、流片到封测,每个环节都要资深的技术人员,芯动经过 16 年的积累,打造一支技术过硬的队伍,后来居上,面对国外厂商的先发优势毫不退让,用实力赢得全球客户认可。
3. 先进工艺流片验证成本高。
先进工艺的 IP 流片验证成本很高昂,设计工时、FinFet 工艺 MPW 或者流片费用、封测等累加,每次验证的费用轻轻松松破百万美元。
某种意义上,芯动在先进 IP 领域获得的优势和业界认可,以及 6 大合作晶圆厂在工艺、流片成本、产能上给予的巨大帮助,都是做先进工艺 IP 的好处。
先进 IP 的重要意义
有和没有先进 IP 区别是很大的,有先进 IP 能够使市场更加理性,同时满足国产高端芯片自主可控、技术迭代的迫切需求!
▲ 芯动科技主办的 2021 国产 IP 与定制芯片生态大会盛况
芯动的先进 IP 技术,一方面引领行业技术的创新,塑造半导体企业的全球化长远发展视野,另一方面填补国内高性能芯片的应用空白,助力国内高端芯片发展。
芯动 16 年来重兵投入全球先进工艺、专注国产自主 IP 研发,在高性能计算平台、多媒体终端&汽车电子平台、IoT 物联网平台等应用领域打造了核心优势,超过 200 次的流片记录、逾 60 亿颗授权量产芯片、10 亿颗以上高端定制 SoC 量产,默默耕耘、脚踏实地,为赋能高端芯片做出重要贡献!
来源:TechWeb



